AZ®1500 Series应用
通用正性光刻胶,具有出色的基材附着力,适用于要求苛刻的湿法蚀刻应用。
• 快速实现高吞吐量
• MIF 或 IN 开发人员兼容性
• 安全溶剂
• 旋涂厚度从 0.5 到 6µm
• 提供染色和未染色版本
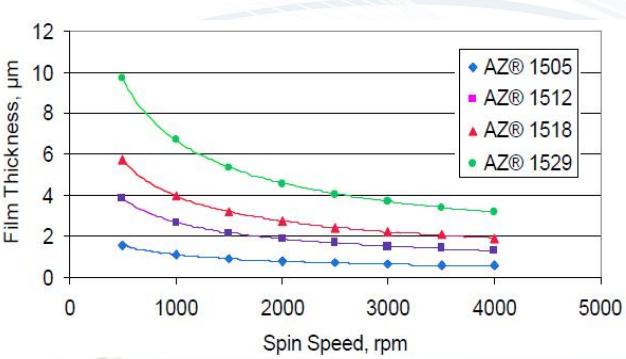
典型过程
软烤:90 至 110C*
曝光:310-450nm 敏感
曝光后烘烤:可选
开发:60s Puddle 或沉浸式
开发人员类型:MIF 或 IN
* 使用较高的软烘烤温度。
对金属的最佳附着力

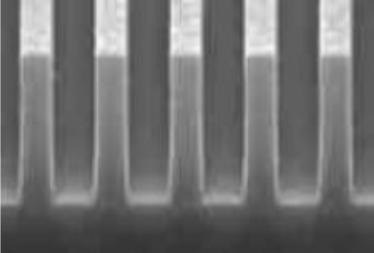
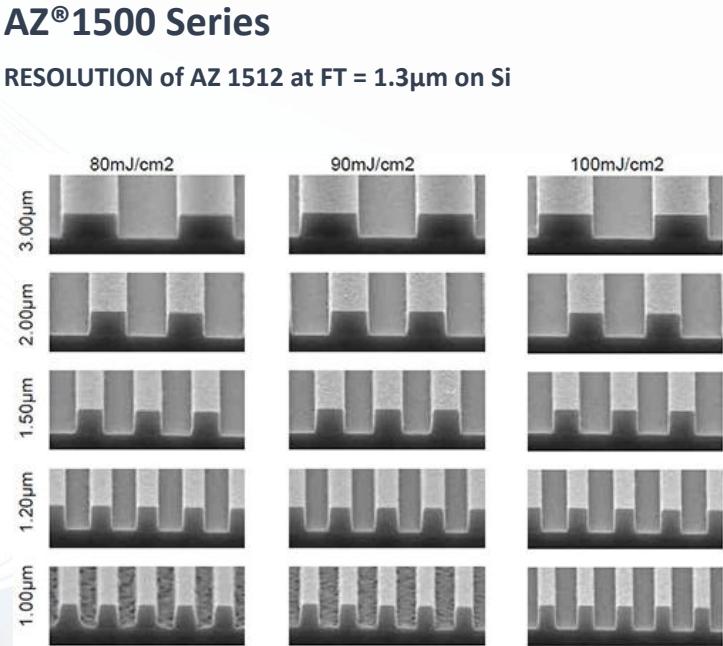
过程注意事项
基板准备
基材必须清洁、干燥且无有机残留物。在涂覆 AZ 1500 之前,应使用 HMDS(六甲基二硅氮烷)或其他合适的底漆对氧化物形成基材(Si 等)进行底漆处理。有关使用 HMDS 进行预处理的详细信息,请联系我们。
涂层
AZ 1500 系列抗蚀剂与所有常见的涂层方法兼容,包括旋涂、喷涂和辊涂。
软烤
最佳软烘烤时间和温度可能因应用而异。建议优化工艺以确保稳定的光刻和粘合性能。 AZ 1500 的软烘烤温度应在 90-110C 范围内。接近该范围高端的温度将提高对金属的附着力。烘烤可以在电炉上或通风烘烤炉中进行。
接触
AZ 1500 对 310 至 450nm 之间的曝光波长敏感。建议使用 365-436nm。
曝光后烘烤
PEB 可用于最大化处理范围并减轻由单色曝光引起的驻波效应。 PEB 温度和时间可能因应用而异。作为一般规则,PEB 温度应在 105 至 115C 范围内。
发展
AZ 1500 系列光刻胶与无金属离子 (TMAH) 和无机(钠或钾基)显影剂兼容。 AZ 400K 1:4 或 AZ 300MIF 显影剂推荐用于槽浸处理,AZ 917MIF 推荐用于水坑显影。
硬烤
硬烘烤(显影后烘烤)可提高湿法蚀刻或电镀应用中的附着力,并提高干法蚀刻工艺中的图案稳定性。硬烘烤温度应在 100 至 110C 范围内,以确保图案的热变形最小。
剥离
在正常工艺条件下,AZ 1500 可在专为 DNQ/酚醛清漆型光刻胶设计的去除剂中轻松剥离。推荐使用 AZ 300T、AZ 400T 和 AZ Kwik 剥离剂。请联系您的 AZ 产品代表以获取应用/基板特定的去除剂建议和数据表。剥离时间可能会因光刻胶图案的热历史而异。经受高加工温度(高于 140°C)的图案可能会交联并变得更难以去除。应注意避免可能烧焦光刻胶图案的过高加工温度。烧焦的光刻胶图案不会溶解在溶剂型去除剂中。


