第三步:倒装芯片组装
此工序是将完成凸点制作的芯片与载板进行倒装互联。
热压倒装技术是芯片与载板连接的常用方法,最合适的凸点材料是金,凸点可以通过传统的电解镀金方法生成,或者采用钉头凸点方法,后者就是引线键合技术中常用的凸点形成工艺。
对于热压倒装技术,由于压力较大,温度也较高,这种工艺仅适用于刚性基底,如氧化铝或硅。另外,基板必须保证较高的平整度,热压头也要有较高的平行对准精度。为了避免半导体材料受到不必要的损害,施加压力时应该有一定的梯度。

第四步:底部填充与固化
倒装连接后已完成了芯片与基板的连接,为了提高倒装稳定性,会在倒装后的芯片与基板之间采用填充胶加固,填胶工艺如下图所示:
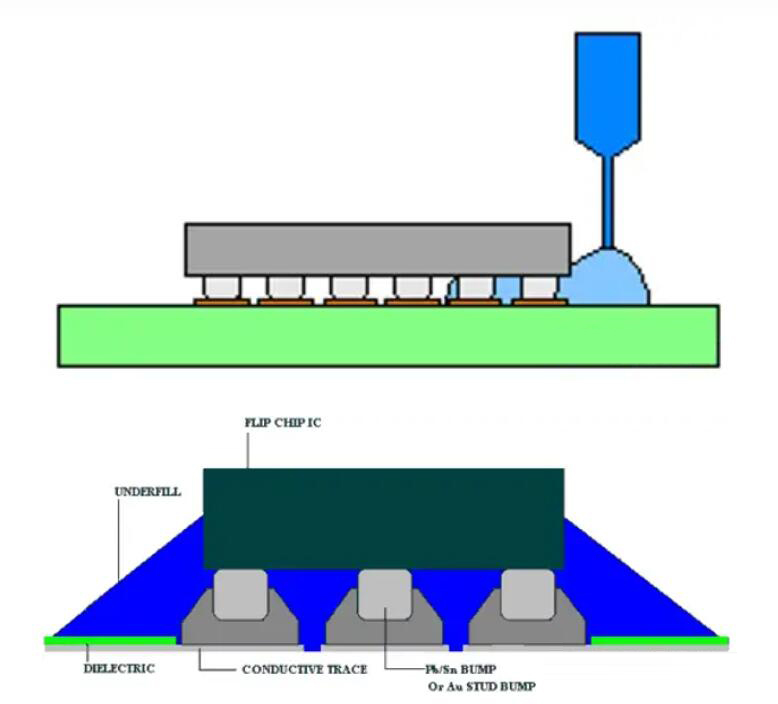
芯片与基底之间的底部填充材料使连接抵抗热疲劳的性能显著提高,如果没有底部填充,则热疲劳将是倒装芯片主要的可靠性问题。
(a)底部填充材料将集中的应力分散到芯片的塑封材料中去。
(b)可阻止焊料蠕变,并增加倒装芯片连接的强度与刚度。
(c)保护芯片免受环境的影响(湿气、离子污染等)。
(d)使得芯片耐受机械振动与冲击。
四、倒装芯片技术总结
与一般的焊点连接一样,倒装芯片连接的可靠性也要受到基板与芯片的热膨胀系数(CTE)失配的影响,此外焊点的高度、焊点之间的最大间距亦会对可靠性造成影响。连接区的裂纹多是在从连接温度冷却下来的过程中产生的。
由于金的熔点温度高,因此它对疲劳损伤的敏感程度远小于焊料。因此,如果在热循环中应力没有超过凸点与焊盘之间的连接强度,那么可靠性不会存在太大问题。
芯片与基底之间的底部填充材料使连接抵抗热疲劳的性能显著提高,如果没有底部填充,则热疲劳将是倒装芯片主要的可靠性问题。
倒装芯片组装非常适用于高频应用领域,因为在这种组装结构中,芯片与基底之间的连接通路非常短。倒装焊点的串连阻抗为1mW左右,串连电感为0.025nH,远小于引线键合中的5-10nH。
正是由于倒装芯片组装的这种优点,信号的传输时延可以显著降低。
五、倒装芯片技术的优点与缺点
(1)倒装连接技术优点:
(a)小尺寸: 小的IC引脚图形 (只有扁平封装的5%)减小了高度和重量。
(b)功能增强: 使用倒装芯片能增加I/O的数量。I/O不像导线键合处于芯片四周而受到数量的限制。面阵列可以在更小的空间里进行更多信号、功率以及电源等互连。一般的倒装芯片焊盘可达400个。
(c)性能增加: 短的互连距离减小了电感、电阻以及电容,保证了信号延迟减少、较好的高频率、以及从晶片背面较好的热通道。
(d)提高了可靠性:大芯片的环氧填充确保了高可靠性。倒装芯片可减少三分之二的互连引脚数。
(e)提高了散热能力:倒装芯片没有塑封,芯片背面可进行有效的冷却。(f)低成本:批量的凸点降低了成本。
(2)倒装连接技术的缺点:
(a)裸芯片很难测试;
(b)凸点芯片适应性有限
(c)随着间距地减小和引脚数的增多导致PCB技术面临挑战;
(d)必须使用X射线检测设备检测不可见的焊点;
(e)和SMT工艺相容性较差;
(f)操作夹持裸晶片比较困难;
(g)要求很高的组装精度;
(h)目前使用底部填充要求一定的固化时间;
(i)有些基板可靠性较低;
(j)维修很困难或者不可能。
关于倒装芯片技术暂时就介绍到这儿!


