今天我们来详细的讲一下CCP刻蚀机。CCP, Capacitive Coupled Plasma, 电容耦合的等离子体。ICP, inductively Coupled Plasma, 电感耦合的等离子体。
CCP 是利用平行板电容器原理来不断激发产生等离子体,射频电源施加在平行板的两极上,工艺气体进入反应腔体中。进入腔体中的反应气体在射频电源的激发下产生等离子体。带电粒子在电场力的作用下,向Wafer 表面不断的轰击,从而去除Wafer 表面的材料,达到刻蚀的目的。
1. CCP刻蚀原理
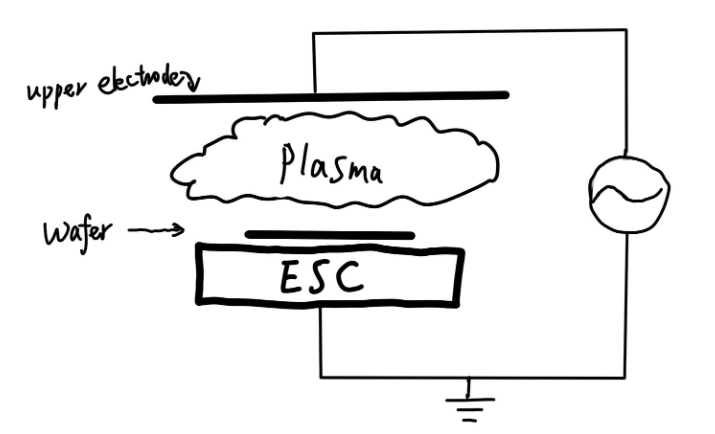
射频电源是产生激发等离子体的重要部件。常用的射频电源频率有400K, 2M, 13.56M, 27.12M, 40M, 60M 等。频率越高,等离子体体在电极板之间的来回震荡越快,来回震荡的等离子体不断撞击气体分子激发更多的等离子体。所以,在CCP中高频射频电源可以调节等离子体的密度,频率越高,激发产生的等离子体密度越高。平行板电容器的上下电极之间有一定的距离,高频的射频电源电场作用在带电粒子上,可能其还没有到达wafer表面就向反方向进行运动了。所以,需要另外一个低频的射频电源来提供带电粒子持续不断的运动电场力,使其运动到Wafer 表面。常用的低频电源有400K, 2M,13.56M 等,低频电场主要起到控制离子轰击能量的作用。

图2 射频波形
图1所示的CCP原理图中,可以看到CCP刻蚀机的构成:上电极板、下电极板、进气系统、射频回路系统、真空腔体系统组成。工艺气体通过气体喷淋头进入真空反应腔体中,气体喷淋头通常作为上电极的一部分组成。进入真空腔体前需要有复杂的混气系统以保证工艺气体进入反应腔体中是均匀的。同时,为了保证工艺的可控,进入的工艺气体需要使用MFC(气体质量流量计)进行精确的控制。
真空反应腔体需要不断的进行抽气,一方面保持反应过程的真空度、另一方面要持续不断的抽出反应产物,排出反应腔体。真空测压计也是刻蚀机中关键的组成部件之一,真空腔体的压力测量、真空泵前级管道压力的测量都需要真空测压计。CCP刻蚀机中在腔体下方设有涡轮分子泵、在涡轮分子泵的前端设有干泵以使得分子泵的前级压力达到工作范围内。
射频电源系统也是CCP刻蚀机中重要的组成部分。其提供了持续不断的能量,来使得工艺气体产生Plasma。
下电极有静电吸盘、射频馈入基座、聚焦环、绝缘环等组件组成。
2. CCP刻蚀机的组成
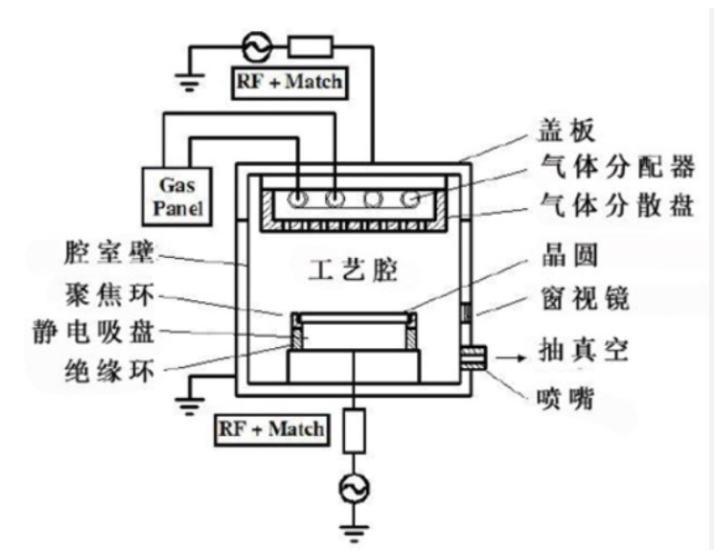
静电吸盘可以看做CCP刻蚀机的核心中的核心部件,Wafer直接作用于其表面,下图所示为静电吸盘的截面图。可以看出其由介电层、加热层、基座、冷却通道等组成,每一层之间的连接尤为重要。最上层介电层的材料决定了ESC 的种类,JR型和库伦型。介电层的材料通常由陶瓷材料构成,如AlN, Al2O3等。
静电吸盘的截面图
刻蚀机是用来去除材料的工艺,去除的对象就是前面工序中的各种薄膜材料或者半导体材料。CCP相较于ICP其能量更高,因此多用于芯片制造的后道工序中。这是由于其本身特性所觉定的。并不是说其不重要,在半导体产线中往往CCP的机台数量会需要更多。因为在后道工序中,需要不断的进行薄膜沉积和不断的刻蚀的步骤重复。继续说回刻蚀的对象,主要有介质材料、金属材料、半导体材料等。
介质材料:电介质在芯片中主要提供器件、栅极和金属互连间的绝缘,主要包括氧化硅、氮化硅、氮氧化硅等。
金属材料:包括钨、铝、金、银等。
半导体材料:Si, 多晶硅等。
CCP主要用于介质材料和金属材料的刻蚀。
来源:部分截取自知乎韶峰

3. CCP刻蚀机在半导体制造中的应用


